30 august 2013 |
Oberflächen POLYSURFACES 03/2013 |
Analysis
Oberflächenanalyse an dünnen Schichten
Marcel Baak, Thomas Nelis und Gerhard Tschopp
Eine elegante und schnelle analytische Methode zur Untersuchung von beschichteten und oberflächenbehandelten Werkstoffen bietet das Glimmentladungsspektrometer GDOES (Glow Discharge Optical Emission Spectroscopy). Dieses Gerät ermöglicht eine quantitative chemische Analyse von metallischen und nichtmetallischen Oberflächen. Die Dicke der analysierbaren Randzone befindet sich üblicherweise im Mikrometerbereich. Mittels GDOES-Analysen lässt sich einerseits die Elementzusammensetzung einer Probe ermitteln und andererseits ein Tiefenprofil (tiefenabhängige Elementzusammensetzung) erstellen.
Dünne Schichten
Wir haben in «Oberflächen Polysurfaces» bereits über das Prinzip der Glimmentladung berichtet [1]. Das Ziel dieses zweiten Beitrags ist es, den Fokus auf die GDOES-Analyse von dünnen Schichten mit einer Dicke <1 µm zu legen.
In den letzten Jahren ist der Trend von beschichteten Produkten und Bauteilen mittels Dünnschichttechnologie (wie CVD, PVD) vermehrt in Richtung dünnere Schichtdicken bis hin zum Nanometerbereich vorgedrungen. Dünne Schichten finden ihre Anwendung in vielen Technikbereichen wie der Mikrotechnik, bei Verschleissschutzschichten, in der Optik oder Solartechnik. Mit der Reduktion der Schichtdicke steigen die Anforderungen an die entsprechenden Analyseverfahren.
Die Analyse dünner Schichten wird in der Regel mittels Röntgen-Photoelektronenspektroskopie (XPS), Auger-Elektronenspektroskopie (AES), Elektronenspektroskopie (ESCA) oder Sekundärionen-Massenspektrometrie (SIMS) durchgeführt. Diese eher teuren Verfahren können häufig durch die wesentlich günstigere GDOES-Methode ersetzt werden, die sich zu einer Konkurrenz für die vorstehend erwähnten Methoden gemausert hat. Dies ist vor allem dann der Fall, wenn die chemische Zusammensetzung der Schicht und der Verlauf der sich darin befindlichen Elemente im Zentrum der Fragestellung steht.
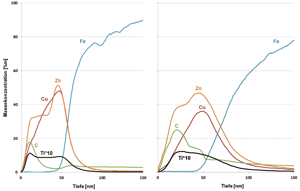
|
Bild 2: GDOES-Analyse einer unproblematischen (links) und einer fehlerhaften Kupfer-Zink-Schicht (rechts).
|
Analyse von dünnen Schichten ...
Auch wenn die GDOES-Analytik ursprünglich nicht für den Bereich von dünnen (<1 µm) Schichten vorgesehen war, kann man heute durch entsprechende Anforderungen an die Messtechnik (Zündverhalten des Plasmas, Sauberkeit der Quelle, optimale Plasmabedingungen und geringe Rauigkeit der Probe) durchaus im Submikrometerbereich exzellente Resultate von Tiefenprofilen erzeugen. Gegenüber anderen Messmethoden ist die Messzeit mittels GDOES bedeutend kürzer.
Das Tiefenprofil in Bild 1 zeigt die GDOES-Messung (Spectruma GDA 750) der obersten Schichten einer Festplatte älterer Generation. Die Messzeit für das Tiefenprofil von 400 nm beträgt etwa 5 s. Mit auf dem Tiefenprofil ist ein typischer rund 2 µm tiefer Messkrater mit einem Durchmesser von 2,5 oder 4 mm, der bei der Messung aus der Probe heraus gesputtert wird (Aufnahme mit dem Sensofar Weisslicht-Interferometer).
Bild 2 zeigt die GDOES-Tiefenprofile von zwei mit Kupfer und Zink beschichteten Federstahlproben: links die Messung der einheitlich beschichteten Probe, rechts die Messung auf einer Verfärbung einer fehlerhaften Schicht. Die Quantifizierung der Messungen zeigt deutliche Unterschiede in der Zusammensetzung der Kupfer-Zink-Schicht. Solche Messungen dienen oft als Grundlage für die Lösungsfindung in fehlerhaften Produktionsprozessschritten.
... bis zu ultradünnen Schichten
Der Begriff der ultradünnen Schicht (Beispiel: Festplatten neuster Generation) wird in der Regel für Schichtdicken im unteren Nanobereich verwendet (<10 nm). GDOES-Analysen solch dünner Schichten auf polierten Oberflächen sind möglich, wenn das GDOES-Gerät die Messparameter innerhalb von Millisekunden stabilisieren und auszulesen vermag.
In extremis können sogar einzelne Atomlagen sichtbar gemacht werden. So gelang es 2004 der Forschungsgruppe um Shimizu sogar, eine Monolage einer Thioharnstoff-Schicht auf einem polierten Kupfersubstrat mittels RF-GDOES nachzuweisen [2].
Literatur
[1] Oberflächen Polysurfaces, 2011, Nr. 5, S. 21
[2] Shimizu K. et al: J. Anal. At. Spectrom., 19, 2004, S. 692-695
Dr. chem. Marcel Baak
Dr. rer. nat. Thomas Nelis
Ing. chem. ETS Gerhard Tschopp
Berner Fachhochschule
Quellengasse 21
2501 Biel
Tel. 032 321 64 17
Fax 032 321 65 00
marcel.baak@bfh.ch
www.ti.bfh.ch


 Subscriptions
Subscriptions